在先进封装和高密度互连不断发展的今天,助焊材料的稳定性与工艺窗口,直接影响良率与可靠性。
DW225水溶性助焊膏,专为倒装焊接(Flip Chip)工艺设计,兼顾性能与量产适配性,为高端封装提供稳定解决方案。
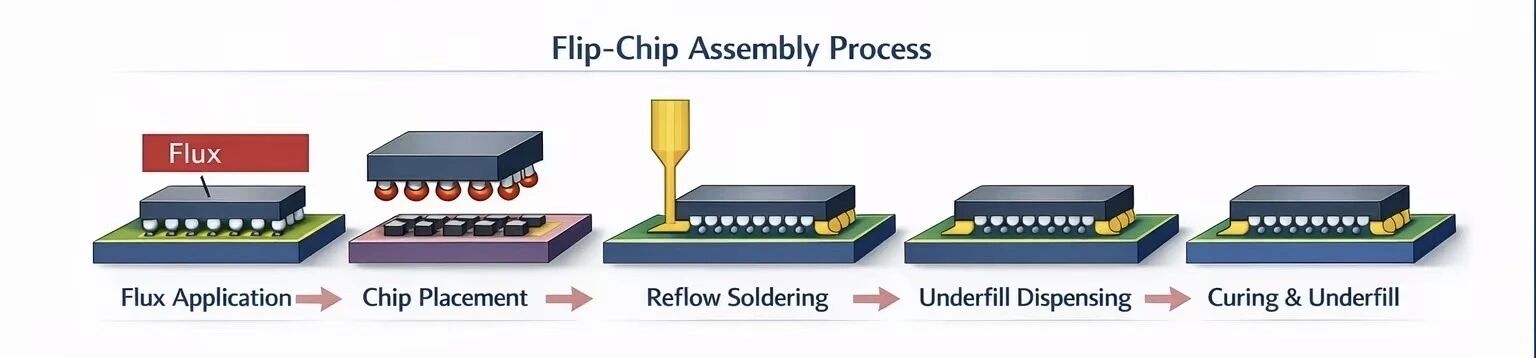 产品简介
产品简介
DW225是一款高性能水溶性倒装焊助焊膏,可有效去除焊点表面氧化物,在焊料自身表面张力作用下,帮助焊点形成均匀一致的半球形结构,避免焊料损失及桥连问题。
同时具备优异的流变性能,既适用于针转移(Dip Transfer),也适用于印刷工艺(Printing),满足多种产线工艺需求。
核心优势(工程师更关心这些)
适用于FC /BGA / WLCSP / FOW / PLP等先进封装
流变性能稳定,适配不同尺寸焊球
支持有铅 / 无铅工艺
长时间针转移性能一致,沉积量稳定
低空洞率,良率高
各类表面可焊性优异
水溶性配方,仅需去离子水即可清洗
关键性能参数
| 项目 | 数值 |
|---|---|
| 颜色 | 黄色至褐色 |
| 粘度(25℃) | 30–40 Pa·s(针转移)100–150 Pa·s(印刷) |
| 适用湿度 | 40–85% RH |
| 保质期 | 180 天 |
工艺价值体现
DW225 不仅是材料升级,更是工艺优化工具:
• 黏度稳定,保证沉积尺寸一致
• 可省略预涂覆助焊剂工序
→ 降低工艺成本
→ 最大程度减少封装翘曲
→ 提升产能(UPH)
• 高黏度 + 快速焊接,有效避免回流过程中的掉球问题
清洗建议
DW225 为水溶性体系,残留物可直接溶于水。
建议批量清洗条件参考:
• 去离子水
• 水温:约55℃
• 喷淋压力:约60 psi
实际参数可根据板尺寸、结构复杂度及设备效率进行优化。
适合应用领域
Bump/ Flip Chip / Wafer/ WLCSP / Fan-Out / 高密度封装 / 晶圆级封装
作为一家国家高新技术企业和科创型企业,东莞市大为新材料技术有限公司在MiniLED锡膏、固晶锡膏 、激光锡膏、水洗/水溶性锡膏等领域拥有丰富的经验和技术积累。我们致力于为微细间距焊接行业提供高质量的锡膏焊接方案,并与国家有色金属研究院、广州第五研究所长期合作。我们的开发团队由化学博士和高分子材料专家组成,在电子焊料领域开发了多元产品,适用于多个领域。
锡膏粒径:5号粉锡膏(15-25μm)、6号粉锡膏(5-15μm)、7号粉锡膏(2-11μm)、8号粉锡膏(2-8μm)、9号粉锡膏(1-5μm)、10号粉锡膏(1-3μm)